Etching : ICP STS (STS multiplex from SPTS)
Description technique :
Chambre à plasma ICP : Inductively Coupled Plasma avec excitation RF.
- Générateur RF pour le plasma (13,56 MHz et 0 à 1200 W) qui contrôle la densité des ions.
- Générateur RF de polarisation (13,56 MHz et 0 à 300 W) qui contrôle l'accélération des ions.
- Gaz disponibles : SF6, CHF3, O2, Ar
- Température de la paroi de la chambre 40°C
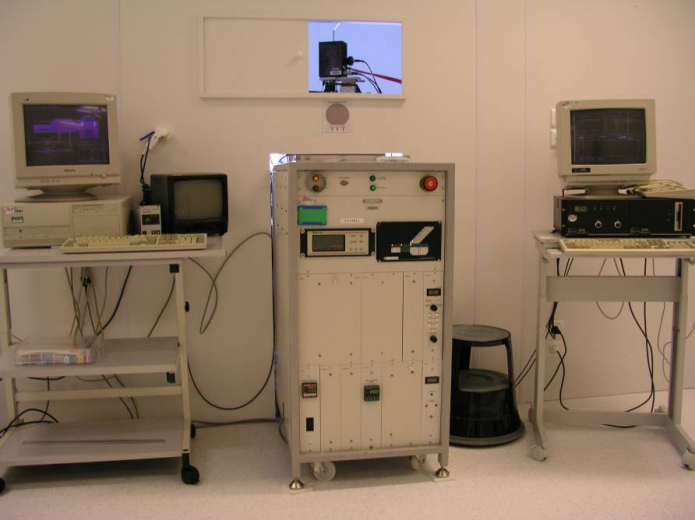
Système de sas de chargement avec transfert automatique vers la chambre à plasma.
Porte-substrat :
- Plaquette de 4" (nécessité d'une plaquette de support pour les échantillons de plus petite taille)
- Système de refroidissement : Système de serrage électrostatique avec contact thermique sur la face arrière.
- Température du porte-substrat de 20°C
Système de détection du point final : système d'interférométrie de Jobin Yvon (longueur d'onde du laser de 900 nm).
Capacités du procédé :
Cet équipement de gravure est dédié aux plasmas avec des gaz fluorés (SF6 et CHF3), notamment adaptés à la gravure des semi-conducteurs (Si, Ge...) et des oxydes ( SiO2, SiN...), et de certains métaux (Ti, Ta...). Les gaz disponibles pour les procédés sont parmi 5 : argon (Ar), oxygène (O2), azote (N2), hexafluorure de soufre (SF6) et trifluorométhane. (CHF3).
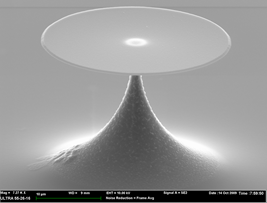 |
 |
| Contact |
marlene.terrier@cea.fr thierry.chevolleau@cea.fr thomas.charvolin@cea.fr |
