IBE etcher (scia Mill 150 from scia Systems)
Source de faisceau d'ions :
Circular microwave ECR-source MW218-e
- gamme d'énergie ionique 50 - 2000 eV, (200 - 800 eV pour les plaquettes 4'')
- densité d'ions (de 0,1 à 0,6 mA.cm-2)
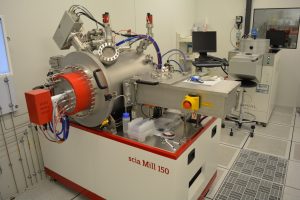
- Ar gas
Porte-substrat :
Refroidi à l'eau, contact de refroidissement arrière à l'hélium, rotation du substrat de 5 à 20 rpm, inclinable in-situ de 0° à 160° par pas de 0,1°.
Neutralisateur : neutralisateur à triple pont de plasma N-3DC
Pression de base : < 1 x 10-6 mbar
Configuration de l'outil : 1 chambre de traitement, 1 sas de chargement
Taille de l'échantillon : du petit échantillon aux plaquettes de 4''.
Détection du point final : Spectromètre de masse ionique à émission secondaire (SIMS) de Hiden analytical, SIMS HAL IMP 301/3F.
Capacités de traitement :
Le système IBE peut être utilisé pour de nombreuses applications dans le domaine des micro et nanotechnologies (spintronique, photonique,..).
Le système IBE permet de graver de nombreux matériaux et des empilements multicouches :
- métal : Pt, Au, Ti, Ta...
- matériaux magnétiques : Fe, Co, Ni, Pd...
- Matériaux piézo-électriques : PZT, STO...
Vitesse de gravure habituelle pour plusieurs matériaux : 21 nm/min pour SiO2, de 25 à 80 nm/min pour Au, de 20 à 60nm/min pour Cu, 16 nm/min pour Ti, 25 nm/min pour Al, 80nm/min pour Ag...

